我院张紫辉教授、黄福平博士团队在工程电子学领域权威期刊《IEEE Transactions on Electron Devices》发表研究论文,题为《1.06 kV Polarization Gate-assisted Si-based AlGaN/GaN Schottky Barrier Diode with 0.817 GW/cm2 BFOM and 10-5 A/cm2 Leakage Current》。

以氮化镓(GaN)为代表的宽禁带半导体功率器件,凭借其出色的高频工作特性、高的功率密度和高的能量转换效率,已成为数据中心、消费电子、电动汽车和光伏并网等关键领域的核心潜力器件,展现出广阔的应用前景。其中,硅(Si)基GaN具有成本低,CMOS工艺兼容、易于集成等优势,因此AlGaN/GaN功率半导体器件在低成本和大规模Si衬底上的异质外延技术成为研究热点。然而干法刻蚀过程会产生表面缺陷;Si衬底与GaN外延层之间存在较大的晶格失配和热失配,在GaN漂移层中产生体缺陷。因此,表面缺陷和体缺陷诱导漏电造成器件过早击穿;同时缺陷对电子的俘获与释放效应导致动态导通电阻增加。针对上述关键科学问题,该团队采用Al0.20Ga0.80N极化栅结构结合凹槽阳极形成沟槽-极化栅复合终端 [见图1(a)] 所示。通过表征分析和仿真计算可以得出,阳极凹槽-极化栅复合终端可以有效降低GaN漂移区的有效电子浓度 [见图1(b)、1(c)和1(d)]。因此,所研制的器件获得了1.38 mΩ·cm2的比导通电阻,~2 × 10-5 A·cm-2关态漏电流和1.06 kV的击穿电压,并将巴利加优值(BFOM)提高至0.817 GW·cm-2(见图2)。由于沟槽-极化栅复合终端可有效抑制缺陷对电子的俘获与释放效应,因此所研制的动态电阻显著降低 [见图3]。该工作为高性能GaN功率器件的开发提供了一种新的技术路径。
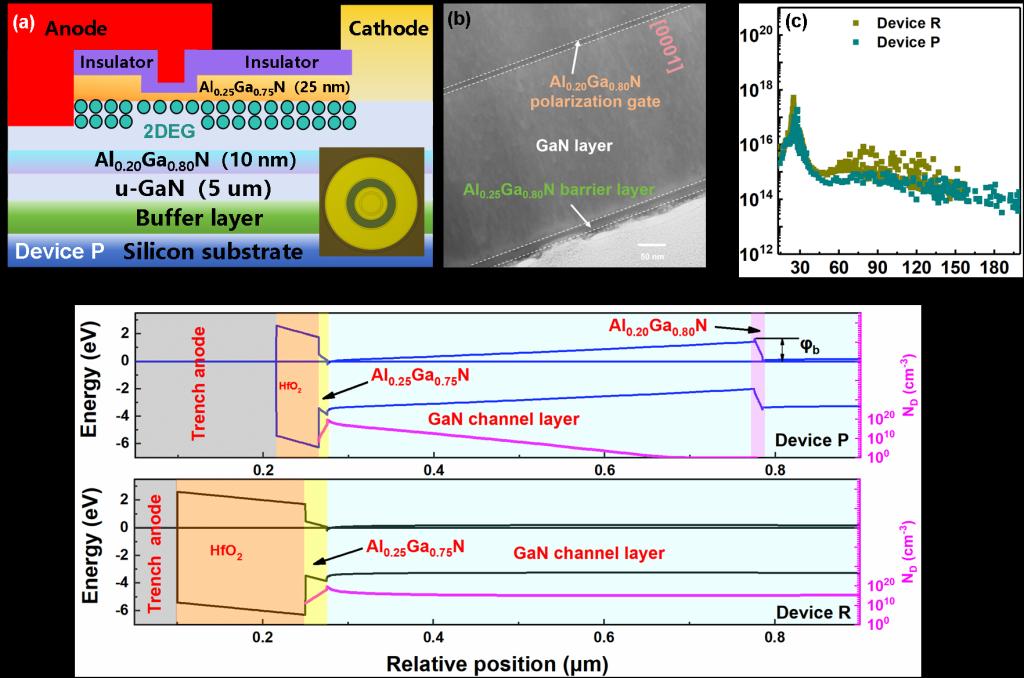
图 | (a) 沟槽-极化栅复合终端Si基AlGaN/GaN功率器件(器件P)的截面示意图;(b) 透射电子显微镜图像;(c) GaN漂移层中提取的背景电子浓度分布;(d) 平衡态下仿真的能带分布和电子浓度分布。

图 |(a)开态I-V特性曲线和Ron.sp;(b)关态I-V特性曲线;(c)功率器件的Ron.sp与BV的指标对比分析;(d) 功率器件开启电压(VON)与漏电流的指标对比分析。

图 |应力时间为50秒时的电应力特性:(a) 器件 R, (b) 器件 P;(c) 应力时间为 50 秒时,动态比导通电阻(Rstress)与静态比导通电阻(Ron,sp)随应力电压的变化关系。
本论文的第一作者为广东工业大学集成电路学院黄福平博士,广东工业大学集成电路学院张紫辉教授为论文通讯作者。广东工业大学集成电路学院为论文第一完成单位。
[1] Huang, Fuping; Mi, Wenjie; He, Jingting; Tian, Kangkai; Chu, Chunshuang; Liu, Haoyan; Zhang, Yonghui; Cai, Shuting; Liu, Yang; Zhang, Zi-Hui. 1. 06-kV Polarization Gate-Assisted Si-Based AlGaN/GaN Schottky Barrier Diode With 0. 817-GW/cm2 BFOM and 10-5-A/cm2 Leakage Current. IEEE TRANSACTIONS ON ELECTRON DEVICES, 2025, 72(12):6918-6923.